Laser Cutter For Silicon Wafer
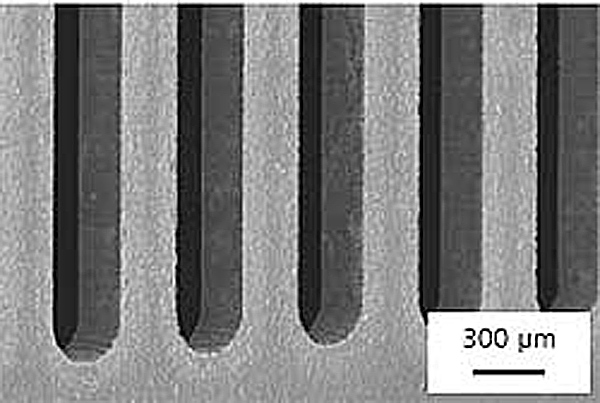
Laser cutting of silicon wafers is possible in all sizes and thicknesses with feature sizes as small as 20 microns.
Laser cutter for silicon wafer. Solutions are available for machining smaller diameter wafers from larger ones solar cell downsizing or silicon stencil cutting. The figure shows 700 µm wafer downsizing top view and side view. However laser ablation has its own problems. Material thickness up to 1mm.
All that is required is a drawing to getting started. Blackstar is a wafer dicing system utilizing fantom width laser dicing technology fwldt invented and patented by laser photonics and modified to accommodate the requirements of a silicon wafer singulation process without affecting the existent dicing method processes or procedures. Due to the reflection it only made slight scratch and could not cut. This is usually followed by a mechanical breaking procedure to produce silicon rectangular tiles for subsequent operations he mechanical break will follow allowing the scribing line offering the least path of resistance.
For silicon wafers less than 100 μm thick laser ablation offers an alternative to the blade technique which is too powerful for the delicate thin wafers. How is laser dicing silicon being processed. Dicing of silicon wafers may also be performed by a laser based technique the so called stealth dicing process. Traditionally silicon wafers have been cut with diamond saws occasionally using a scribe and break process which have the limitation that they can only cut straight lines and suffer from edge chipping and frequency doubled vanadate lasers which are both slow and expensive to operate as is the microjet process.
It works as a two stage process in which defect regions are firstly introduced into the wafer by scanning the beam along intended cutting lines and secondly an underlying carrier membrane is expanded to induce fracture. Sapphire silicon wafer cutter. Demonstration of cutting features into 1 5 mm thick silicon wafers using a laser micromachining system equipped with a qcw laser. In addition complex features such as channels and pockets and channels can be machined in silicon wafers.
Vaporizing the wafer with a laser along the dicing path creates molten debris and microcracks. The same system can be used to downsize larger silicon wafers for use in smaller format processing tools. We tried cutting a silicon wafer with fabool laser mini 1 6w and 3 5w model. Scribing causes partial cut lines on the wafer.